Release date:2018-01-29
The Capillary Underfill process consists of dispensing a void-free fluid to encapsulate the bottom side of a silicon die or BGA device. Encapsulation covers the top surface, typically where fragile interconnects are located, but in the case of Capillary Underfill, the fragile interconnects are located on the underside of the component. Underfilling enhances the connection strength of electrical contacts and compensates for differences in thermal expansion rates of the two joining materials that could lead to product failure. Underfill is typically used for applications in high shock environments or when consistent reliability is required.
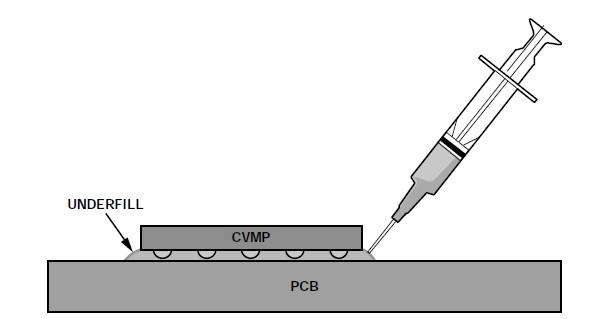
E-mail:trade@kintai.cn
Address:Buliding G5, No.39 Ruihe Road,Huangpu District, Guangzhou, 510000, China